Скальпирование процессора своими руками
Добавил пользователь Евгений Кузнецов Обновлено: 05.09.2024
С выходом четвертого поколения процессоров intel Core под названием Haswell, мной был приобретение процессора intel Core 4770K, надежды и мечты были огромные, но все было омрачено перегрев, о разгоне выше 4,1 MGz можно было забыть смело и навсегда. Всему виной стал новый термоинтерфейс между теплораспределительной крышкой и кристаллом процессора. Так почему intel стал применять пластичный термоинтерфейс вместо припоя?
О скальпировании intel 4770k и роли теплораспределительной крышки я уже писал ранее и только теперь можно смело сказать по чему intel намерено на протяжении долгих лет использует тонкие чем надо крышки.
Этот вопрос не давал покоя мне долгое время и я стал изучать более детально все составляющие компоненты процессоров начиная с линейки Haswell. В одно и то же время линейка процессоров на socket 2011, 2011-3 спокойно использует под теплораспределительной крышкой припой.
Припой, как все выглядит.
В настоящее время процессоры производятся и имеют внешний вид кремниевой микросхемы. Кремний является основным материалом для создания процессоров, обладая кубической кристаллической решеткой можно создавать идеальные слои на атомном уровне. Таким образом после создания интегральной схемы, на аерхней части подложки будут размещены металлизированные площадки для соединения чипа с печатной платой, припой в виде шариков обеспечит надежность соединения чипа. Сама матрица чипа, будет производить и выделять достаточно большое количество тепла, относительно своих физических размеров, по этому нужен хороший теплоотвод . Одновременно возникает другая проблема в текстолите socket LGA, его толщина всего около 1,17мм (процессор Haswell ), но процессор Skylake имеет толщену текстолита около 0,78 мм. Текстолит будет давать идеальное подключение к контактам LGA в гнезде материнской платы . Главная проблема, как соединить кристалл, изготовленный из кремния и теплораспределительную крышку, произведенную из меди. Медь имеет теплопроводность около 400 Ват, плюс она доступна. Есть много способов все это соединить, но реально мы столкнемся с множеством факторов, самый главный — это максимальная температура которую может выдержать чип кремния и теплопроводность совместимых материалов.

Вся правда о пайке или скальпирование CPU
На рисунке видно как схематично выглядит процессор intel поколений lvy Bridge, Haswell, Skylake. Видно что, подложка соединяется с печатной платой через столбики припоя, которая в конечном итоге соединяет процессор с socket LGA. Виден так называемый не долив, тот что на печатной плате, основание и выступающая часть имеют разные коэффициенты теплового расширения, таким образом недолив защищает процессор от саморазрушения, вызванного разностью коэффициента теплового разрушения. Теплораспределительная крышка будет проводить тепло от подложки к радиатору, который будет крепиться на теплораспределительную крышку сверху. Термоинтерфейс должен быть пластичным и должен компенсировать все движения из-за разности теплового расширения, без повреждений кристалла процессора. В зависимости от типа процессора, между подложкой и теплопроводящей крышкой, можно применять обычную термопасту или припой.

Вся правда о пайке или скальпирование CPU
Как паять кремний и медь?
Кремний и медь совершенно разные материалы, кремний ( Si ) имеет внешний вид металла, но остается по восприятию как стекло (SiO2 ) , тоесть хрупок. Теплопроводность довольно хорошоя, примерно 150 Вт / (м * К) и тепловое расширения относительно низкое 2,6 мкм / (м * К).
Медь (Cu) это пластичный металл, обладает очень хорошей электропроводностью и теплопроводностью. Тем не менее тепловое расширение большое 16,5 мкм / (м * К), это больше в 6 раз, чем у кремния. Как все спаять, обычный оловянный припой, на пример такой Sn60Pb40, подходит отлично для пайки медных проводов, не подойдет, все припои на основе олова не прилепают к кремнию. Кроме того, затвердевание олова ведет к большому тепловому напряжению внутри материала. Это тепловое напряжение может вывевти из строя кристалл процессора. Известный материал способный прилипнуть к меди и кремнию это Индий. Одновременно с этим застывающий индий не дает большой усадки, это приводит к небольшому коэффициенту термического напряжения внутри кристалла процессора. Теплопроводность индия не так высока как у меди, равна (300 K) 81,8 Вт/(м·К). Кроме того индий очень пластичен, это позволяет подложке, относительно теплораспределительной крышке, расширяться без повреждений. Индий имеет температуру плавления 157 ° С.
Пайка процессора с крышкой.

Вся правда о пайке или скальпирование CPU
Привычной для нас пайкой тут не отделаешься, крышка из меди а кристалл из кремния, при этом сроки эксплуатации готового процессора составляют многие годы, это накладывает особый отпечаток на качество работ. По этому нужно правильно и качественно подготовить все составляющие для пайки, это теплораспределительная крышка и подложка ( кристалл процессора). Теплопроводящая крышка (платина) покрыта слоем никеля (Ni), никель будет работать в качестве диффузионного посредника для качественного соединения с медью. Индий тоже цепляется за никель но не так хорошо как хотелось, поэтому понадобится еще один слой, желательно из благородного металла, на пример золото (Аu), серебро (Ag) или палладий (Pd), поскольку может обеспечить более стабильное прилипание. Золото по всем параметрам подходит лучше для пайки. Золото нужно наносить на пластину слоем 1-3 мкм.
Припой.
Как было описано выше, индий является единственным материалом который годится для использования. В зависимости от формы индия мы должны удалить оксидный слой перед пайкой. Это может быть сделано путем селективного травления с использованием хлористоводородной кислоты. Слой индий должен быть толстым, чтобы обеспечить достаточное количество циклов тепловом расширения без образования трещин, при многократных термических процессов. И мы не можем припоять индий к кристаллу процессора, так как индий будет диффузировать в кремний, что не избежно со временем выведет чип процессора из строя. Таким образом нужен еще один диффузионный барьер слой на верхней части чипа. Диффузионный барьер формируется из нескольких слоев, выполненных из титана (Ti), никель (Ni) и ванадия (V). Сверху этого бутерброда, лежит слой золота для лучшего прилепания индия.

Вся правда о пайке или скальпирование CPU
Процесс пайки.
Итак получилось: Никелерованная теплораспределительная крышка сверху, снизу слой золота для связи с индием, еще ниже три слоя, титан, никель + ванадий и золото. Температура пайки должна быть не выше 170 ° С. Меньше температура может привести к плохой диффузии всех компонентов а высокая к выходу из строя процессора. В процессе пайки будут образовываться сплавы из некоторых компонентов. После пайки видно что золото, индий и никель образуют сплавы различной толщины. Теперь теплораспределительная крышка припаянна к кремнию и готова к работе.

Вся правда о пайке или скальпирование CPU
Самое не приятное.
В процессе пайки индий будет сокращаться, в результате поверхность кремния и крышки будут стягиваться, в результате выходит кривая поверхность теплораспределительной крышки. Интенсивное термоциклирование может привести к повреждению припоя , напряжение при растяжении внутри припоя приведет к образованию пустот. Раз за разом, примерно за 200-300 термических циклов, это неизбежно приведет к образованию трещин в припое по углам на припое чипа кремния, это не избежно приведет к образованию трещин на сомом кремнии что выведет процессор из строя. Появление пустот и трещин в основном зависит от площади припоя на кристалле кремния, то есть чем больше площадь кремния тем лучше. Малый размер кристалла, ниже 130 мм ² , а это старые знакомые — lvy Bridge, Haswell, Skylake будут способствовать образованию пустот а затем и трещин, при чем это не избежно. Тем не менее процессоры среднего и большого размера кристалла, выше 270 мм ² а это Haswell-E socket 2011 не показывают значительного образования трещин при термоциклировании.
Вот и ответ на главный вопрос, для чего инженеры intel не применяют припой а используют термопасту. Отсюда тонкая и кривая теплораспределительная крышка процессора, должна играть, компенсируя сжатие. Так что я не вижу другого объяснения, более чем логического. С другой стороны по чему такая плохая эта термопаста.






Все материалы добавляются пользователями. При копировании необходимо указывать ссылку на источник.
Разгон процессора
Для экспериментов с разгоном Intel Core i7-4770K было использовано напряжение питания CPU Cache 1.1 В, Input Voltage 1.8 В.
Воздушное охлаждение
реклама
Как и ранее при тестировании процессоров AMD, помимо изучения возможности увеличения штатной частоты, будет проверена и работа режимов с заниженным напряжением питания ЦП. Точкой отсчета выбрано минимальное напряжение, требуемое для стабильной работы на частоте 3 ГГц, для стендового экземпляра такой отметкой стал уровень 0.84 В.
Результаты Core i7-4770K с воздушным охлаждением:

График температурного режима:


Вот такая вот картина, его потребление едва ушло за границу 120 Вт, а температура уже превышает отметку в 90 градусов. Помнится, AMD FX-8150 на воздушном охлаждении не перегревался и при потреблении свыше 300 Вт.
реклама
Такая вот борьба за пряморукость пользователей и за повышение их уровня умений. Возможно, с выходом Haswell неплохо выросли продажи тисков и жидкого металла, то есть в Intel постарались не только на благо повышения навыков пользователей, но и попутно помогли заработать совершенно сторонним производителям и продавцам!
Ну да ладно, шутки шутками, а все же для дальнейших экспериментов не обойтись без скальпирования процессора. Немногим ранее wildchaser посвятил этой теме одну из своих статей, где перечислил существующие методы скальпирования ЦП, а также показал, какой разницы в температурном режиме можно ожидать.
Скальпирование процессора
Было решено снимать крышку в тисках методом сдвига:

С одной стороны тисков процессор упирается текстолитом, с другой стороны – своей крышкой. В итоге она сдвигается относительно текстолита. Для того чтобы CPU легче поддался механическому воздействию, не помешает его прогрев феном. Чем выше температура, тем раньше поддастся герметик, который скрепляет крышку и текстолит (в районе ядра процессор термопастой не удерживается).

Как видно по фотографии выше, термопасты в Intel не пожалели, такого количества хватило бы на три-четыре процессора. Затвердеть паста еще не успела, но высохла изрядно, не исключаю, что за время гарантии качество теплопередачи ухудшилось бы еще сильнее, чем есть сейчас.
После снятия крышки осталось только нанести на нее жидкий металл (ЖМ-6). Из мер предосторожности посоветую закрыть цепочку конденсаторов скотчем (или, чем-то другим на свое усмотрение), все же случайное попадание туда жидкого металла обернется долгими чистками и потерянным временем.


реклама
Сравнение разгона на штатном процессоре со скальпированным:

Собственно, в дополнительном комментировании график не нуждается, разницу в разгоне видно невооруженным взглядом.
График изменения температурного режима:

реклама
При напряжении питания 1.19 В разница составила 19 градусов (на самом деле больше, по причине переменчивого климата, тесты скальпированного процессора производились при большей комнатной температуре). Интересно, что с ростом напряжения питания увеличение температурного режима остается более-менее плавным, так что есть надежда на существенные подвижки при переходе от воздушного охлаждения к жидкостному.
Кстати, сопоставив графики разгона и температур, можно заключить, что при пересечении процессором отметки в 80-85 градусов его отклик на увеличение напряжения ухудшается. Этим можно объяснить и 50 МГц разницы на 1.19 В после смены термоинтерфейса.
Влияние напряжения питания CPU на энергопотребление:

По сравнению с графиком процессора до операции скальпирования, здесь по большему количеству точек (протестированных режимов) уже можно делать какие-то выводы. Не сказать, чтобы каждый последующий шаг напряжения питания сильно влиял бы на энергопотребление, но если сравнивать через несколько точек, то смотреть на разгон можно по-разному.
реклама
К примеру, возьмем энергопотребление ЦП для напряжения питания 1.14 В и 1.34 В, разница составляет 68 Вт или 1.64 раза, а разница в разгоне? Всего 383 МГц или 1.09 раза. Понятно, что это не остановит того, кто гонится за максимальной производительностью, но если таковой цели нет – возможно, стоит задуматься о целесообразности разгона.
Подпишитесь на наш канал в Яндекс.Дзен или telegram-канал @overclockers_news - это удобные способы следить за новыми материалами на сайте. С картинками, расширенными описаниями и без рекламы.

Егор Морозов | 19 Июня, 2017 - 11:30

Наверное многие, кто следят за новинками в компьютерном мире, замечали, что в последнее время, с выходом процессоров Intel Skylake и Core i9, профессионалы говорят о том, что их нужно скальпировать для нормального разгона. Давайте разберемся, что же это за термин — скальпирование, и нужно ли оно вообще.
Внутреннее устройство процессора
Неверно полагать, что сам кристалл процессора выглядит так, как на фото слева. На самом деле то, что мы видим — это крышка процессора, а сам он гораздо меньше и находится под ней (фото справа):
Сам процессор представляет из себя бутерброд: сначала идет кристалл, потом слой термоинтерфейса, и сверху — крышка:
И вся проблема в том, что чем больше слоев — тем хуже идет перенос тепла, и тем больше греется непосредственно сам кристалл процессора. И тогда возникает резонный вопрос — а зачем вообще нужна эта крышка, почему нельзя установить систему охлаждения непосредственно на сам кристалл? Можно, и в ноутбуках так и делают: поверх кристалла сразу ставится пластина с тепловой трубкой до кулера:
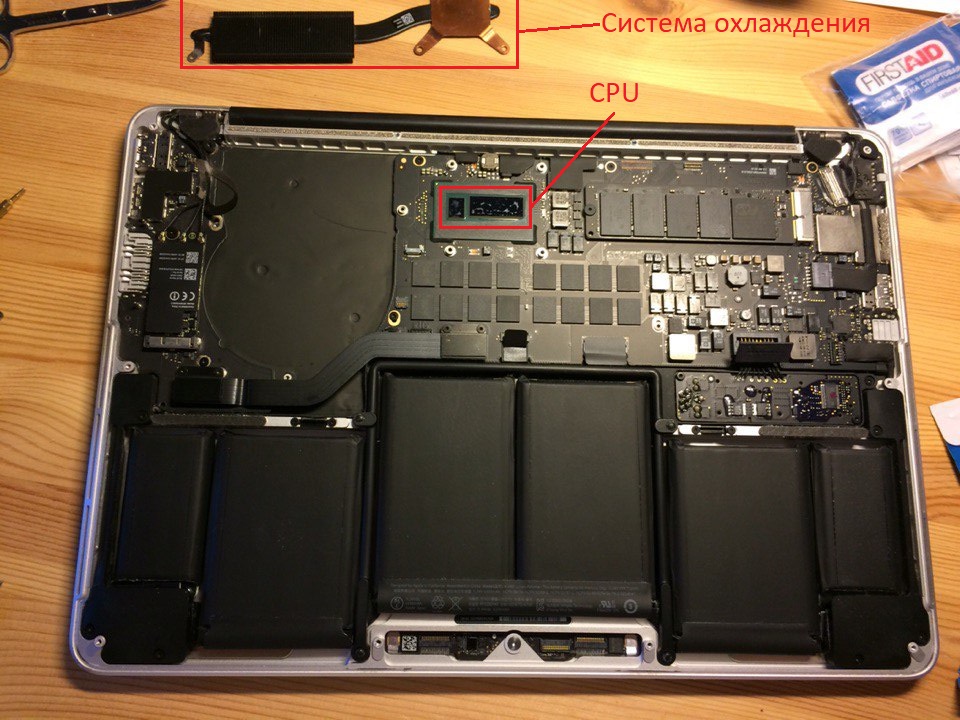
Но вот вся проблема в том, что мобильные процессоры имеют тепловыделение зачастую меньше 50 Вт, и одной-двух термотрубок вполне хватает. А вот с топовыми десктопными процессорами с TDP в 140 Вт это не пройдет, поэтому нужны огромные кулеры, весом зачастую в 500-700 грамм. И проблема заключается в том, что кремниевый кристалл очень хрупкий, и при установке такого кулера его легко расколоть, что, разумеется, приведет к неработоспособности процессора. Поэтому для защиты над процессором устанавливается медная крышка, ну а между ней и непосредственно кристаллом для лучшей передачи тепла делается термоинтерфейс.
Теплопроводность самой крышки вопросов не вызывает — медь является отличным проводником тепла. Но вся загвоздка заключается в том, чтобы сделать нормальный термоинтерфейс между крышкой и кристаллом. Изначально использовался припой — его теплопроводность в среднем вдвое хуже, чем у меди, что все еще было достаточно хорошо. Плюсом идет то, что со временем припой не теряет своих свойств.
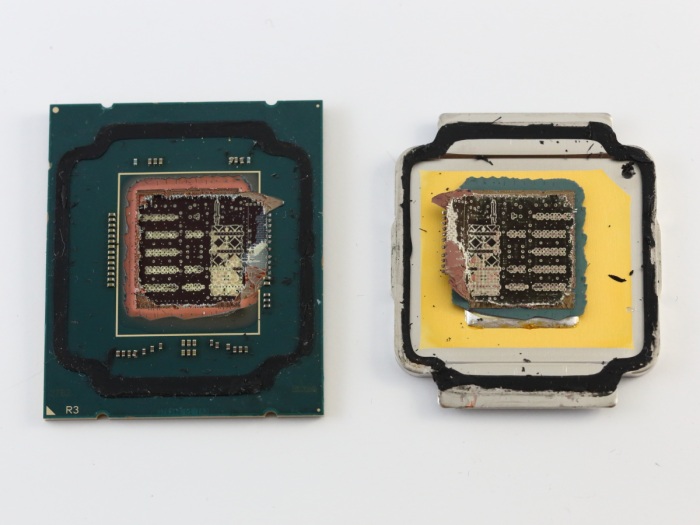
Скальпирование в домашних условиях
На YouTube полно видео о том, как вроде бы легко и просто можно снять крышку процессора дома. Однако мой совет — обратитесь к профессионалу, ибо при неудачном скальпировании процессор стоимостью в два десятка рублей можно будет просто выкинуть:
Тут проблема в том, что нужно не только не помять текстолит, но и не сбить ни один из компонентов обвязки процессора. Для тех, кто все же хочет рискнуть — можно купить специальную машинку для скальпирования: вы помещаете в нее процессор, аккуратно двигаете поршень и крышка отваливается. Но вот цена такого устройства составляет порядка 30-40 долларов — за скальпирование одного процессора с вас возьмут где-то так же. А с учетом того, что топовые процессоры, да еще и разогнанные, имеет смысл менять раз в 4-5 лет, а новые процессоры скорее всего в такую машинку банально не поместятся — смысла ее покупать нет.
В итоге, если вы решили собрать топовый компьютер на процессорах от Intel, то рано или поздно вам все же следует его скальпировать. Пользователей с процессорами не K-линеек это практически не касается — там невозможен разгон, да и дефолтные частоты достаточно низкие, так что установка хорошего кулера обычно полностью решает проблему с перегревом. AMD в этом плане гораздо лучше — в Ryzen используется припой, то есть никакой головной боли со склаьпированием нет. Но увы — не для всех задач он подходит хорошо, так что конечный выбор, что же брать, остается за вами.
Читайте также:

